服务热线
0755-83031562
 点击:336次责任编辑: 鼎佳诺达
点击:336次责任编辑: 鼎佳诺达
 时间:2025-01-16
时间:2025-01-16
台积电在台湾各地兴建新晶圆厂,扩大产能,以满足不断增长的 CoWoS 和 AI 市场需求。

Total CoWoS Capacity (WPM= Wafer Per Month):
2023: 13,000 ~ 16,000 WPM
2024: 35,000 ~ 40,000 WPM
2025e: 65,000 ~ 75,000 WPM
2026e: 90,000 ~ 110,000 WPM
台积电先进封装CoWoS(晶圆上芯片)技术的快速增长受到以下几个关键因素的推动:
对高性能计算 (HPC) 的需求:对高级 AI、机器学习和数据中心应用的需求日益增长,需要像 CoWoS 这样的创新半导体封装技术来处理更高的计算工作负载。

系统集成方面的进步: CoWoS 能够在单个基板上集成多个芯片、内存和逻辑封装,满足对更高带宽、更低延迟和更高能效的日益增长的需求。
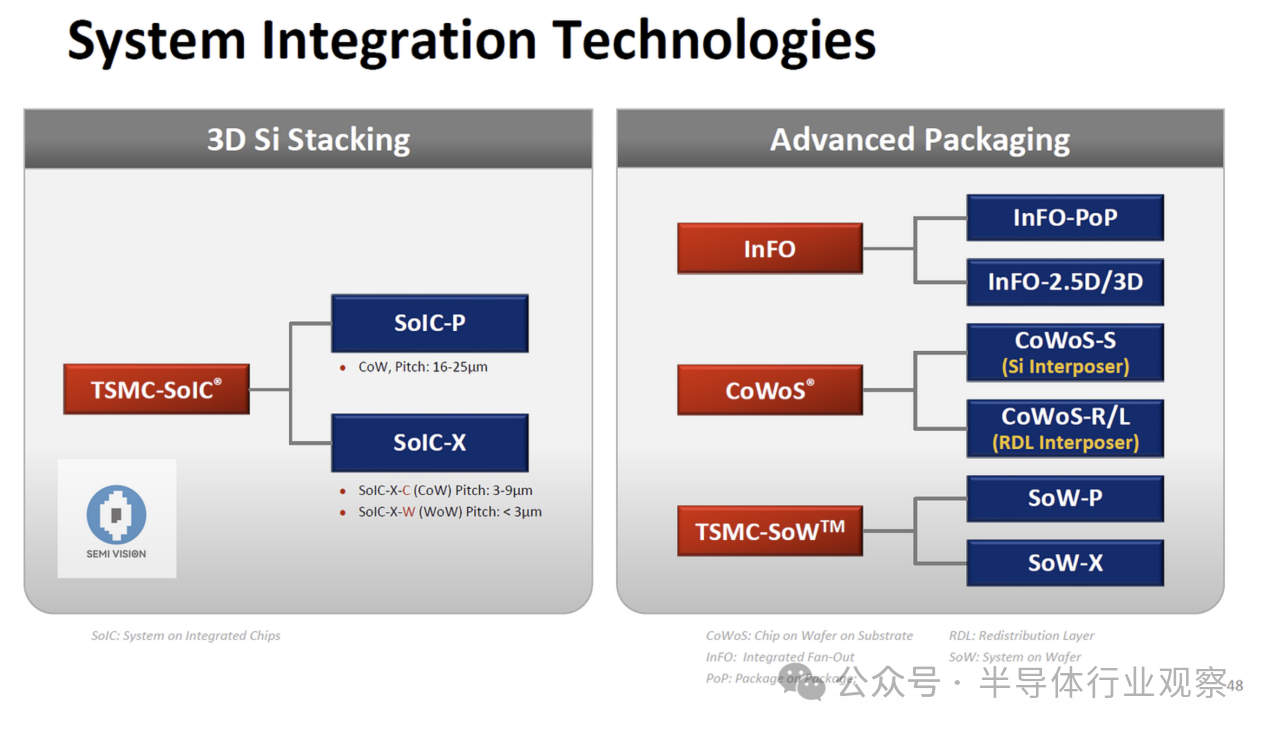
2.5D 封装市场不断增长:CoWoS 是 2.5D 集成领域的领导者,它结合了高密度互连和大规模芯片集成,以提高整体系统性能。
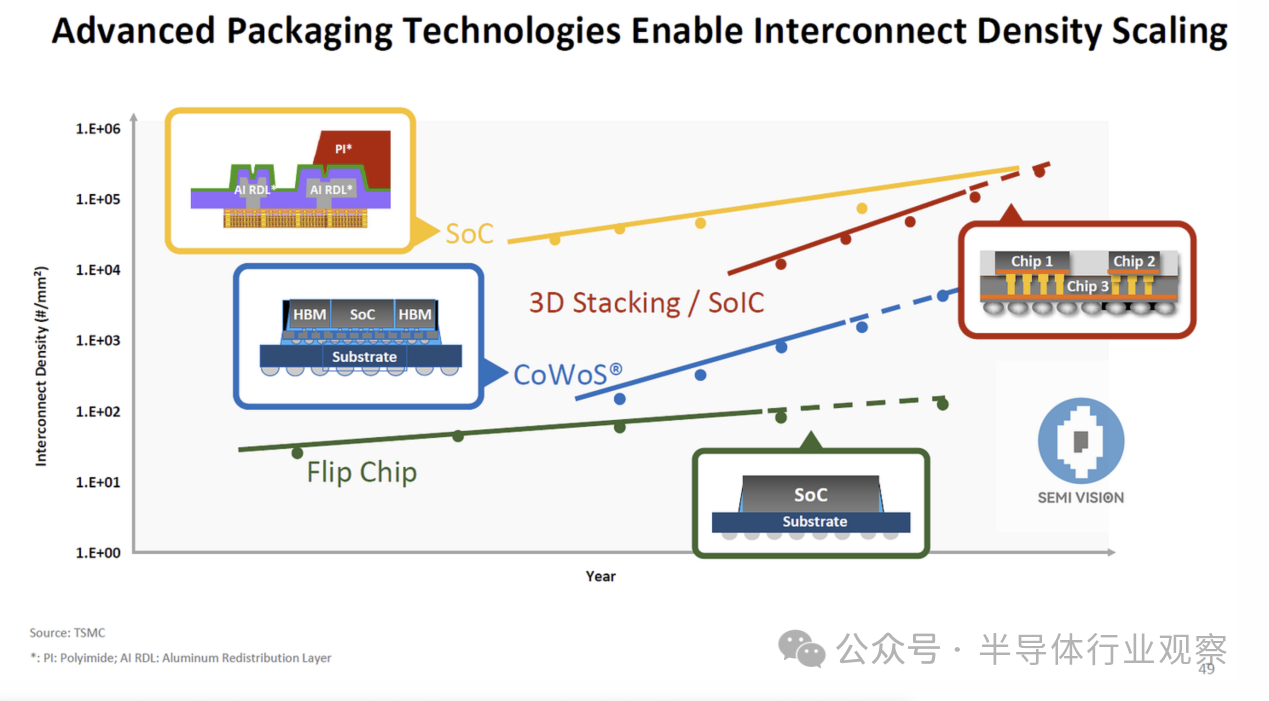
半导体设计复杂性不断增加:随着半导体尺寸缩小变得越来越具有挑战性,CoWoS 提供了一种可扩展的解决方案,用于生产满足现代电子产品需求的异构集成芯片。
其他 2D/2.5D 封装供应商:ASE VIPack、Absolics、英特尔 EMIB、三星 I-cube、Amkor、SPIL。
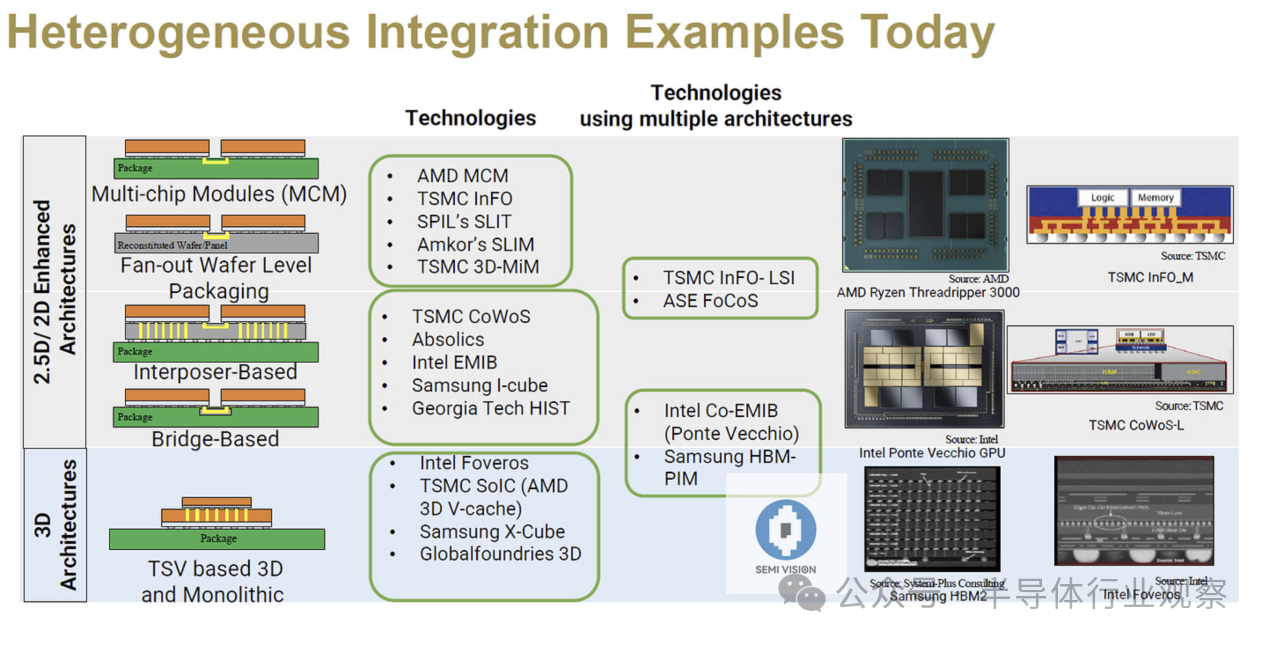
为何3D IC封装比2.5D更好?
NVIDIA 领跑 2025 年全球 CoWoS 容量需求份额:

VIDIA在容量需求方面占据主导地位,占据总需求的63%,表明其在采用 CoWoS 技术方面的领导地位。
紧随其后的是博通,占13%,是 CoWoS 需求的第二大贡献者,尽管远远落后于 NVIDIA。
AMD和Marvell各占8%,并列第三,表明两家公司对这项技术的兴趣相当。
其他贡献者包括AWS + Alchip(3%)、英特尔(2%)、Xilinx(1%)和其他(3%),所占份额要小得多,表明他们对 CoWoS 容量的依赖相对有限。
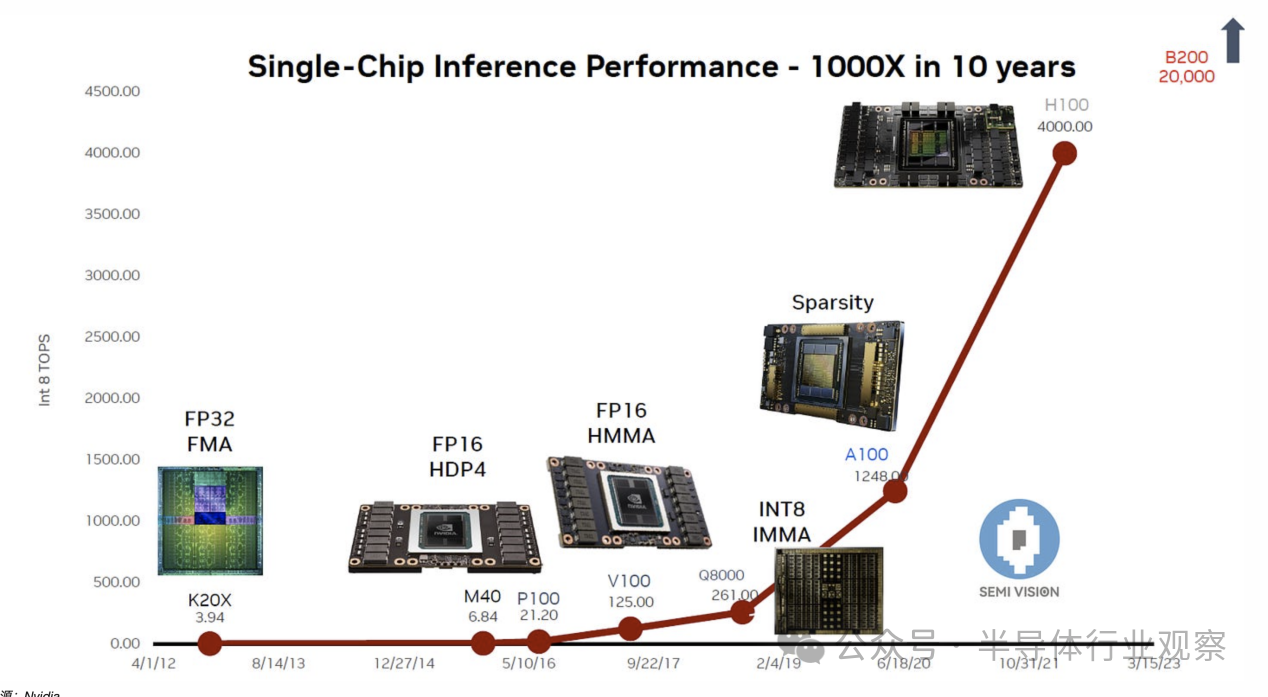
NVIDIA 对 CoWoS 技术的高需求主要源于其在开发高性能计算和人工智能 (AI) 硬件方面的领导地位。这种需求的主要原因包括:
适用于 AI 和 HPC 的先进封装:CoWoS 技术使 NVIDIA 能够将多个高带宽内存 (HBM) 芯片与其 GPU 封装在单个基板上。这对于需要大量计算能力和内存带宽的 AI 训练、推理和 HPC 至关重要。
人工智能和机器学习蓬勃发展:NVIDIA 的 GPU 是全球人工智能和机器学习系统的核心。各行各业人工智能应用的快速增长大大增加了对 CoWoS 等先进封装解决方案的需求,以满足性能需求。
数据中心领导地位:NVIDIA 主导数据中心市场,其 GPU 用于大规模 AI 训练和推理任务。CoWoS 技术可实现更高的性能和能效,是 NVIDIA 数据中心产品必不可少的技术。

Chiplet 架构:CoWoS 支持 NVIDIA 向基于 Chiplet 的架构迈进,从而实现模块化设计和更好的可扩展性。这对于其下一代产品尤其重要。
关键行业的需求:人工智能、法学硕士、自动驾驶汽车和科学研究等行业严重依赖 NVIDIA GPU 来实现人工智能驱动的解决方案,进一步推动了对 CoWoS 技术提供尖端性能的需求。
台积电加大 CoWoS 产能扩张:
全台先进封装厂全面开工!
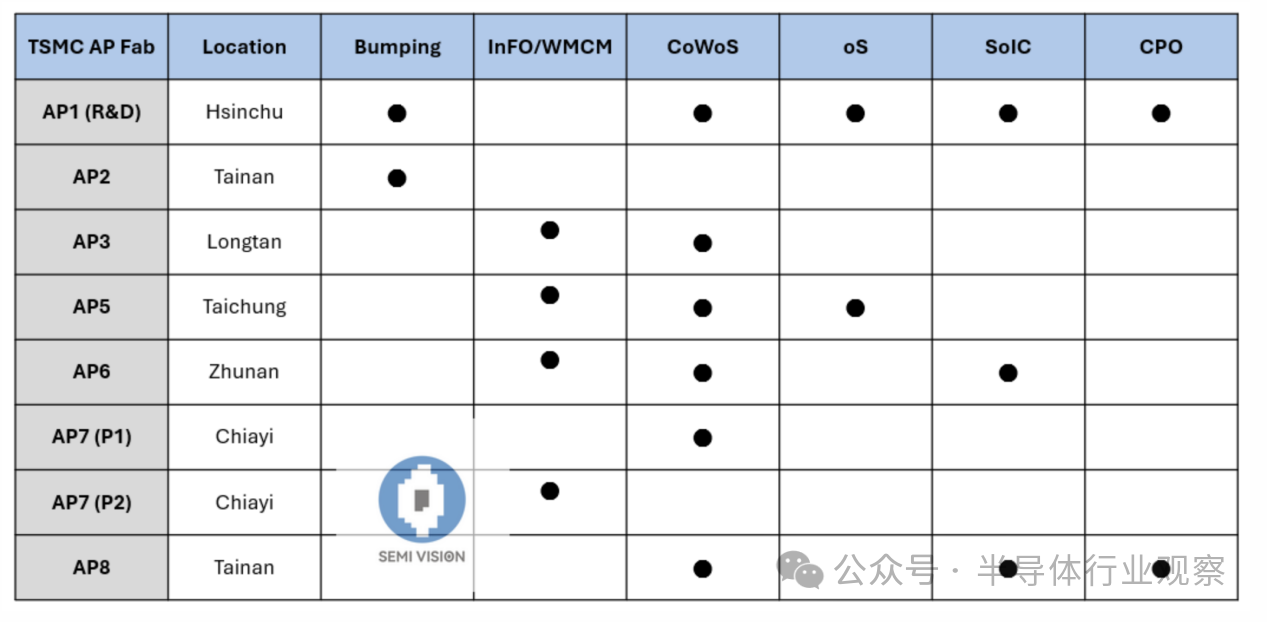
台积电加速先进封装扩张计划,竹南、嘉义、台中、台南等地新厂正全速运转。竹南先进封装AP6B厂于12月3日获使用证,嘉义厂于今年5月动工,工程进度迅速,钢结构初现雏形。台中AP5B厂预计明年上半年投产,群创台南厂区台南AP8厂(内部代号AP8)则计划于2025年底小规模投产,
台南AP8厂预计于2025年底逐步投产。预估新厂建筑面积可支持每月4-5万片产能,不过台积电将整座厂区用于CoWoS生产的可能性不大。相反,它计划整合 SoIC(集成芯片系统)、CP(光子芯片封装)和 FoPLP(扇出面板级封装)的产能,作为其战略多元化的一部分。
参考链接
https://semiwiki.com/forum/index.php?threads/cowos-capacity-set-to-skyrocket-by-2026-massive-growth-in-advanced-packaging.21773/